支持在CPU/GPU上堆疊HBM內存,三星SAINT-D封裝技術今年商用
6月18日消息,據《韓國經濟日報》報道,三星將于今年推出高帶寬內存 (HBM) 的 3D 封裝服務,該報道援引了三星日前在美國圣何塞舉行的 2024 年三星代工論壇上的聲明以及“業內消息人士”的說法,三星 3D 封裝技術基本上將為2025 年底至 2026 年的HBM4集成鋪平道路。
對于 3D 封裝,三星此前就曾推出了一個名為 SAINT(三星先進互連技術)的平臺,其中包括三種不同的 3D 堆疊技術:用于 SRAM 的 SAINT-S、用于邏輯的 SAINT-L 和用于在CPU或GPU等邏輯芯片之上堆疊 DRAM 的 SAINT-D 。
其中,三星在2022年正式宣布推出 SAINT-D 之后,已經研發了數年,預計今年將正式商用,這將是全球最大內存制造商和領先代工廠的一個重要里程碑。
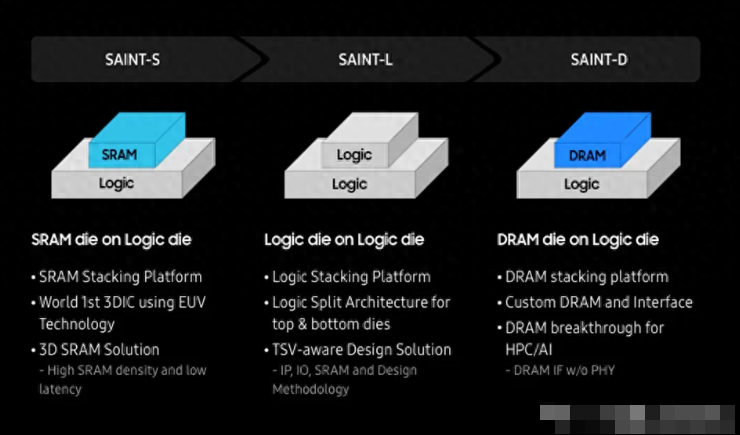
三星的新型 3D 封裝方法涉及將 HBM 芯片垂直堆疊在處理器頂部,這與現有的通過硅中介層水平連接 HBM 芯片和 GPU 的2.5D 技術不同。這種垂直堆疊方法消除了對硅中介層的需要,但需要使用復雜的工藝技術制造的用于 HBM 內存的新基片。
3D 封裝技術為 HBM 提供了顯著的優勢,包括更快的數據傳輸、更清晰的信號、更低的功耗和更低的延遲,但封裝成本相對較高。三星計劃以交鑰匙服務的形式提供這種先進的 3D HBM 封裝,其內存業務部門生產 HBM 芯片,代工部門為無晶圓廠公司組裝實際的處理器。
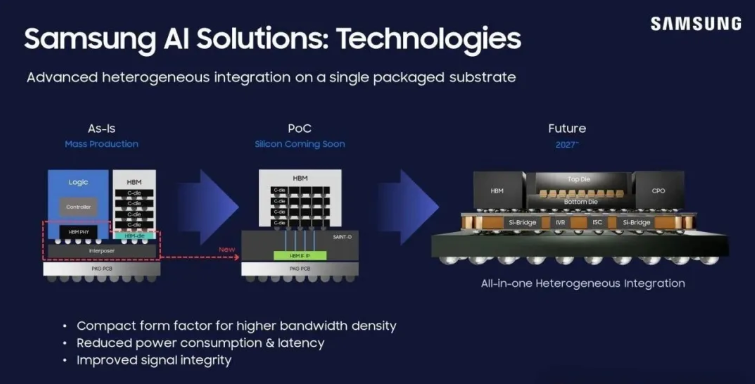
目前尚不清楚的是,三星今年計劃用 SAINT-D 提供什么產品。將 HBM 放在邏輯芯片上需要適當的芯片設計,目前尚不清楚還有其他公司將 HBM 放在其他芯片頂部,并計劃于 2024 年至 2025 年上半年推出。
展望未來,三星的目標是到 2027 年推出一體化異構集成技術。這項技術將實現兩層邏輯芯片、HBM 內存(在中介層上)甚至共封裝光學器件 (CPO) 的集成。
編輯:芯智訊-林子
*博客內容為網友個人發布,僅代表博主個人觀點,如有侵權請聯系工作人員刪除。











