實時上市加成本優勢 SiP在高整合芯片技術脫穎而出
2010年最受終端市場矚目的熱門電子產品,就非Apple所推出iPad的Tablet PC莫屬。iPad尺寸規格為長24.5公分、寬19公分、高1.3公分,重量則僅介于0.68~0.73公斤間,與一般筆記型計算機(NB)規格相較,長寬高大約分別為26公分、37.5公分、3公分,重量則約達2.5公斤,無論是體積或重量,iPad皆較NB易于攜帶。
本文引用地址:http://cqxgywz.com/article/113354.htmiPad之所以能達到短小輕薄的設計要求,除采用LED背光與投射式電容多指觸控等技術外,半導體組件高度整合亦是重要因素之一。
從 iPad所采用新型A4微處理器縱剖面觀察,主要由3層芯片堆棧而成,最上面2層為三星電子(Samsung Electronics)1Gb的Mobile RAM,顯示內含2Gb內存,相當于每顆晶粒的內存容量為128MB,合計為256MB。
第3層則為A4微處理器的裸晶,3層芯片則以系統級封裝(System in Package)技術之一的層迭封裝(Package on Package;PoP)技術封裝于同一顆IC之中。
實際上,不止是iPad,包括iPhone在內的智能型手機、高容量記憶卡與儲存裝置、數字相機(DSC)與可攜式多媒體播放器等消費性電子產品,早已采用SiP技術整合與封裝內部半導體組件,而且采用SiP的滲透率與單位使用顆數都將持續增加。
另一方面,在制程持續微縮的同時,不止讓SoC的設計時間與設計難度提升,投片前的前置費用更是倍數成長,成本競爭優勢持續喪失中,更將有利于SiP為終端電子產品市場所接受。



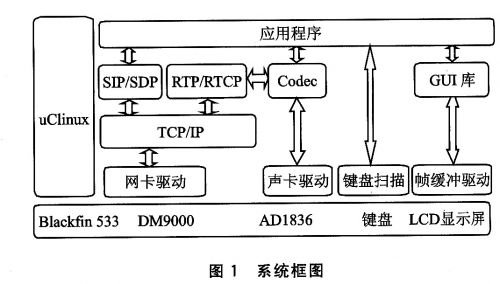





評論