應用筆記 | 成功實現LDO穩壓器熱設計的6大步驟
通常我們使用LDO穩壓器IC(以下簡稱LDO),可以簡單地實現DC-DC轉換。作為電壓調節工具,LDO在輸入輸出電壓差小的時候效率非常好,但是在電壓差大的時候,由于其工作特性,會導致較高的功率損耗并發熱嚴重。
本文引用地址:http://cqxgywz.com/article/202506/471260.htm因此,適當的熱設計對于確保產品長期可靠性工作至關重要。如果忽視熱設計,可能會因過熱而導致性能下降,最壞的情況下會使設備故障。一旦出現問題,就要重新選擇元器件、修改電路板、重新設計散熱等,對日程和成本產生巨大影響。
羅姆提供了一些關于熱設計的應用說明,以提高產品的可靠性并減少設計階段的返工。此白皮書只介紹其中的一部分。
應用手冊的說明
圖1展示了在開發過程中,羅姆為用戶提供的工具和支持。

圖1. 羅姆提供的設計支持工具
此應用手冊是用戶在開發過程中各階段所需技術信息的匯總文檔,提供了從基礎到實踐的全方位支持。 本文將通過6大步驟,介紹如何完善LDO熱設計。
步驟1:了解LDO工作原理
步驟2:估算結溫
步驟3:考慮降低溫度的各種措施
步驟4:利用熱仿真
步驟5:進行最佳的電路板設計
步驟6:準確地進行熱測量
步驟1:了解LDO工作原理
由于熱設計會涉及到LDO的功率損耗,因此有必要了解LDO的工作原理。首先請根據《 線性穩壓器的基礎 》(圖2)來確認線性穩壓器的效率。根據該應用手冊的公式3,效率可由 ???? = ???? ???????????? / ???? ???????? ×100[%] 計算得出,輸入輸出間的電壓差越大,效率越低。換句話說,輸入輸出間的電壓差越大,功率損耗和發熱就越大。記住這一點進行下一步。

圖2. 線性穩壓器的基礎
步驟2:估算結溫
向上滑動查看詳細介紹
制作電路板前,由于實際溫度無法測量,所以要通過理論來估算溫度。結溫是根據LDO的功率損耗、封裝熱阻、PCB熱阻和環境溫度等參數估算出來的、這一步驟請參考《 線性穩壓器的熱計算 》(圖3)。

圖3. 線性穩壓器的熱計算
在進行估算時,必須要知道每個參數。結溫的絕對最大額定值因設備不同而不同,但規格書中一定會記載相關信息。例如,典型LDO的最高結溫為150°C(圖4)。
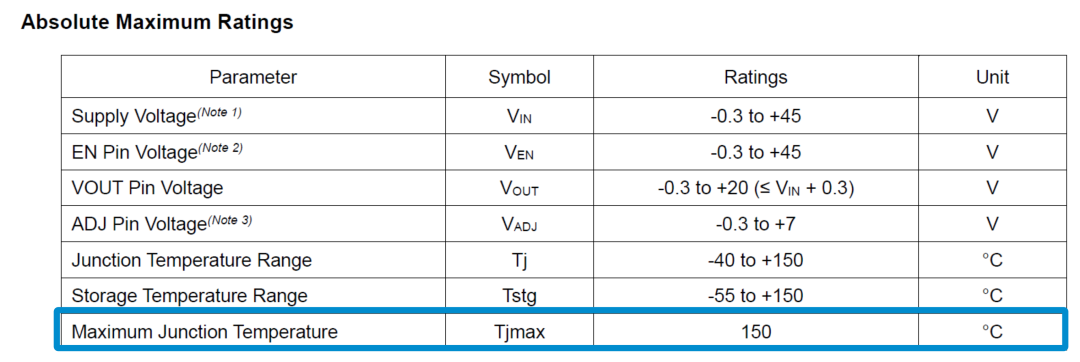
圖4. 規格書上列出的結溫的絕對最大額定值 BD9xxN5-C系列 為例
封裝的熱阻也是規格書中必須列出的信息之一(圖5)。

圖5. 規格書上列出的封裝的熱阻 BD9xxN5-C系列 為例
當負載電流隨時間變化時,需要使用瞬態熱阻抗來求得結溫。在《 使用瞬態熱阻抗計算結溫的方法 》中,如(圖6),總結了根據瞬態熱阻抗計算結溫的方法。

圖6. 使用瞬態熱阻抗計算結溫的方法
在LDO的輸出有大容量電容器的情況下、啟動時會給輸出電容充電,產生一個大的沖擊電流。結溫不能因這個過電流而超過額定值。確認方法總結在《 根據沖擊電流計算結溫 》(圖7)。

圖7. 根據沖擊電流計算結溫
傳統TO220封裝的3端子穩壓器,使用散熱片的熱設計文檔,請參考《 3端子穩壓器的熱設計 》。

圖8. 3端子穩壓器的熱設計
步驟3:考慮降低溫度的各種措施
到目前為止的估算中,當結溫超過最大額定值時,需要考慮各種各樣的條件,一般詳情總結如下。
IC封裝
?選擇熱阻較低的封裝,例如更大的封裝尺寸、焊盤外露或帶有散熱FIN的封裝。
PCB
?增加PCB的銅箔厚度。
?擴大PCB的銅箔面積。
?增加PCB層數。
?優化散熱孔的配置。
外圍器件與應用方式
?通過串聯二極管或電阻器分散發熱源。
?對LDO進行級聯連接,分散發熱源。
?把電源系統分成多個,分散發熱源。
?降低輸入電壓減小LDO的壓差以提高效率。
?提高輸出電壓減小LDO的壓差以提高效率。
?考慮使用開關穩壓器。
步驟4:利用熱仿真
在熱設計中,和電氣設計一樣,仿真也是一種有效的手段。尤其是聯合仿真,即同時對電氣和熱學兩方面進行仿真,有助于分析電子元件和電路的熱學行為,優化設計并提高可靠性。
ROHM Solution Simulator可進行在線實時仿真并即時查看結果。圖9是 線性穩壓器IC仿真示例 ,在輸入電壓,PCB類型和環境溫度等不同條件下對結溫進行估算。另外,每個仿真電路都配有User’s Guide。


圖9. 線性穩壓器IC仿真示例 和 User's Guide
此外,在熱設計中的仿真當中,使用三維熱流體的仿真。在多個熱源相鄰,或使用強制風冷、水冷的情況下,雖然可以進行復雜的計算,但為了追求精度,需要包含內部結構、熱物理性質等信息的詳細模型。由于缺乏詳細模型的統一標準,仿真工具之間無法兼容,不同公司的模型質量也參差不齊。雖然精度比詳細模型低,但羅姆在Web上公開了雙熱阻模型。雙熱阻模型在仿真工具之間具有兼容性,所需分析時間也較少,所以適用于在設計初期大致決定電路板尺寸和元器件位置,以及不同封裝之間的相對差異。在《 熱仿真用 雙熱阻模型 》(圖10)中是關于雙熱阻模型的說明、在《 雙熱阻模型的使用方法 》(圖11)中說明了如何下載雙熱阻模型以及如何使用熱仿真。根據不同的用途,可以有效的使用不同的仿真方法。但是,最終還是需要實測來進行判斷。

圖10. 熱仿真用 雙熱阻模型

圖11. 雙熱阻模型的使用方法
步驟5:進行最佳的電路板設計
向上滑動查看詳細介紹
近幾年的技術趨勢是產品小型化和重視設計為導向,要求在有限的體積內放置多個元器件。在電路板設計中,考慮電氣特性、EMC(電磁兼容性)和散熱特性是非常重要的,這些特性的良好平衡可以實現高可靠性的電路板設計。因為產品不同,優先度也不同,所以沒有絕對的答案、在《 PCB Layout 熱設計指導 》(圖12)中描述了在PCB(印刷電路板)設計時降低熱阻抗的關鍵點,以及當多個熱源相鄰時的影響。

圖12. PCB Layout 熱設計指導
另外,根據不同的產品,還準備了其他封裝的熱阻數據,如《 TO252封裝熱阻抗信息 》(圖13)所示,請靈活使用。在步驟2中提到的瞬態熱電阻的數據也包含在其中。

圖13. TO252封裝熱阻抗信息
貼片功率IC的封裝背面有散熱焊盤,可以提高散熱效率。散熱焊盤通過回流焊連接到PCB板的銅箔表面,但如果此處使用的焊盤網板尺寸設計不當,就會出現安裝問題。《 元器件引腳焊盤網板的設計方針與示例 》(圖14)提供了網板的設計指南。

圖14. 元器件引腳焊盤網板的設計方針與示例
樣機完成后,必須對其進行檢查,以確保其按設計完成。這里重要的是溫度測量。用ΨJT估算結溫時使用熱電偶。《 使用熱電偶測量溫度時的注意事項 》(圖15)重點介紹了在使用熱電偶測量溫度時容易出現問題的關鍵點,并提供了實際測量結果。另一種方法是利用芯片中二極管的正向電壓來估算結溫。《 使用pn結的正向電壓測量溫度的注意事項 》(圖16)介紹如何正確選擇二極管和測量方法。

圖15. 使用熱電偶測量溫度時的注意事項

圖16. 使用pn結的正向電壓測量溫度的注意事項
最后,必須根據估算的結溫做出判斷。根據開發階段和應用結構的不同,估算結溫的方法也不同。《 熱評估判定標準 》(圖17)介紹了幾種估算結溫的方法,可以作為判斷的依據。

圖17. 熱評估判定標準
結論
本應用手冊分步驟介紹了關于提高產品可靠性和減少設計階段返工所需的熱設計信息。此外,還從元器件選型到仿真,評價,PCB板制作的每個流程準備了最適合的解決方案,致力于解決用戶的課題。羅姆相信,這些內容有助于加快開發速度,預防問題和故障的發生。



評論