半導體清洗技術
就干法清洗來說,它正用于有選擇的、大多是表面清理的步驟。例子之一是無水HF(AHF)/乙醇溶解工藝,它在多種應用中能有效地從Si表面除去本來有的或化學生成的氧化物。圖2是各種表面加工運作中執行AHF/乙醇溶解工藝的25片晶圓和3片晶圓商品反應器的示意圖。圖3中的AFM結果說明,執行工藝沒有損傷Si表面。
本文引用地址:http://cqxgywz.com/article/106346.htm
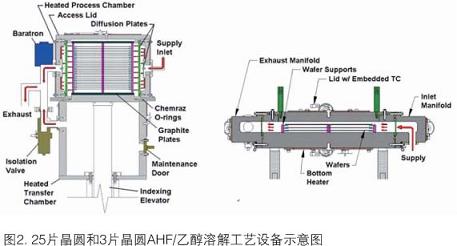
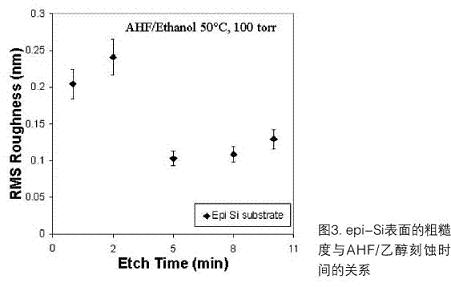
干燥晶圓是任何濕法清洗程序的組成部分。廣泛認可的基于IPA的晶圓干燥方法使清洗工藝的這一關鍵部分有了很大的進步,這些方法采用Marangoni干燥及其衍生方法。
無論在批次清洗工藝還是在單晶圓清洗工藝中,傳統的浸沒清洗仍起主導作用。在單晶圓清洗工藝時,這一趨勢由于太陽電池清洗技術的需求而強化。該技術中,由于被加工襯底的剪切數目(shearnumber),可選用批次加工方法。圖2所示反應器說明,可以使選擇氣相清洗化學過程與批次加工兼容。但同時,單晶圓清洗方法(如旋轉清洗)正推進到高端應用領域。
當前與未來的挑戰
為了半導體清洗技術能滿足不斷出現的新需求,必須對現有工藝進行調整和修改。隨著縱向尺寸持續縮小,清洗操作過程中的材料損失和表面粗糙就會成為必須關注的領域。將微粒去除而又沒有材料損失和圖形損傷是最基本的要求,因此必須考慮周全并有所折衷。像兆頻超聲攪動這樣的物理輔助手段對結構損傷和圖形坍塌等有潛在影響,正在對其改進,以便在保持微粒去除工藝效率的同時不對圖形完整性產生有害影響。考慮到表面形態的原子級惡化都可能對器件性能會有致命影響,即使像DI水清洗等這些看起來最良性的清洗程序元素也必須重新評估。
為了減少某些器件機構中的圖形坍塌及相關損傷,氣相化學作用(例如前面談到的與有機溶劑蒸汽混合的無水HF(AHF))可望越來越有用。
為了應對硅表面的非平面性問題,晶圓清洗技術至少受到三個不同前沿加工技術的挑戰。首先涉及的是CMOS加工。在器件幾何形狀不斷減小時,尖端數字CMOS技術方面的挑戰是保持柵結構有足夠的電容密度,這是在柵長度減小時維持足夠高驅動電流所需要的。一個途徑是采用比SiO2介電常數高的柵電介質,另一途徑是通過三維結構MOS柵極以增加柵面積又不增加單元電路面積,再一個途徑就是二者的結合。
土壤濕度傳感器相關文章:土壤濕度傳感器原理
















評論