使用 p-GaN 屏蔽提高開關(guān)速度
電力電子產(chǎn)品的銷售額預(yù)計將在這十年及以后飆升。推動這一趨勢的是電動汽車產(chǎn)量的增加和數(shù)據(jù)中心的增長,由于人工智能的采用,數(shù)據(jù)中心的電力需求更加苛刻。
對于使用電力電子的每種應(yīng)用,提高其效率都是有益的。收益可能包括增加行駛里程、減少電費、減少供暖和減少碳足跡。
由于卓越的效率帶來的這些優(yōu)勢,基于寬禁帶半導(dǎo)體的器件越來越多地被采用。到目前為止,基于 SiC 的 MOSFET 創(chuàng)造了最多的收入,其中 MOSFET 因贏得電動汽車部署而成為頭條新聞。
然而,盡管取得了很大的成功,SiC 器件也存在一些重大缺陷。它們包括 SiC 和 SiO 之間的接口2,這遠非完美。

圖 1.Panasonic 的垂直 JFET 采用 p-GaN 屏蔽結(jié)構(gòu),由于反向傳輸電容降低,可實現(xiàn)卓越的開關(guān)。
橫向氮化鎵晶體管避免了這些問題,它已經(jīng)通過主導(dǎo)移動設(shè)備快速充電市場而獲得了可觀的銷售額。此類器件可以在大面積、低成本的硅襯底上生長,其優(yōu)點之一是無需摻雜即可實現(xiàn)高水平的遷移率。相反,利用內(nèi)部極化產(chǎn)生二維電子氣體 (2DEG)。
這種橫向器件是氮化鎵晶體管的一個重要里程碑,提供了第一個“殺手級”應(yīng)用——智能手機、平板電腦和筆記本電腦等產(chǎn)品的優(yōu)質(zhì)快速充電裝置。但是,對于這些橫向器件來說,超越這一點絕非易事,因為要達到輸出電流和擊穿電壓的高值,從而達到輸出功率的較高值是非常具有挑戰(zhàn)性的。對于這種器件幾何形狀,高功率的關(guān)鍵設(shè)計考慮因素是電極的面積,以及器件表面的源極和漏極之間的間距。
提供了一條非常有前途的前進道路是一種新的架構(gòu),涉及從橫向幾何形狀到垂直幾何形狀的轉(zhuǎn)變。在過去幾年中,許多團隊一直在開發(fā)這些更緊湊的器件,源極和漏極被放置在基板的相對兩側(cè),使設(shè)計工程師能夠擴展晶體管的功率,同時不會顯著增加其占地面積。
我們公司松下是垂直 GaN 晶體管的開拓者之一。我們開發(fā)了一種變體,即高功率垂直 GaN JFET,我們稱之為 VJFET。它是使用 p-GaN/AlGaN/GaN 通道的再生長生產(chǎn)的。
為了使氮化鎵器件在系統(tǒng)級充分發(fā)揮其潛力,它們有望幫助小型化和微調(diào)損耗,它們必須能夠?qū)崿F(xiàn)高速開關(guān)。控制這一關(guān)鍵指標的是反向轉(zhuǎn)移電容(也稱為柵極和漏極之間的電容),它會影響柵極和漏極之間的電容充電所需的鏡像周期。

圖 2.松下制造具有p-GaN屏蔽結(jié)構(gòu)的垂直JFET的工藝。
傳統(tǒng)的 VJFET 受到高反向傳輸電容的阻礙,這與柵極和漏極的相反放置有關(guān)。但我們最近通過對器件進行了突破性的改進來解決這個問題:在原生襯底上生長的常關(guān) GaN VJFET 上添加 p-GaN 屏蔽(有關(guān)其結(jié)構(gòu)的詳細信息,請參見圖 1)。
模擬見解
為了評估和了解該設(shè)備的優(yōu)點和影響,我們模擬了它的性能。這是以傳統(tǒng)的VJFET為基準的,VJFET將常關(guān)工作與低導(dǎo)通電阻相結(jié)合,并在V型槽上形成了重新生長的p-GaN柵極/AlGaN/GaN結(jié)構(gòu)。
我們新型 VJFET 在 V 形槽上戰(zhàn)略性地引入了 p-GaN 屏蔽層,該屏蔽層與源極具有相同的電位。對于該器件,柵極與 p-GaN 屏蔽結(jié)構(gòu)分開在平面上形成。由于 p-GaN 阱和 p-GaN 屏蔽結(jié)構(gòu)在柵極和漏極之間進行了有效的屏蔽,這種設(shè)計的反向傳輸電容遠低于傳統(tǒng)設(shè)計。
對兩種形式的 VJFET 的仿真表明,我們對該晶體管的改進在很寬的漏源電壓范圍內(nèi)顯著降低了反向傳輸電容。在高達 500 V 的電壓范圍內(nèi),我們的器件具有遠低于皮法拉的反向傳輸電容,而其傳統(tǒng)器件的反向傳輸電容值為數(shù)十皮法。這些仿真還表明,縮短p孔邊緣和p-GaN柵極之間的長度可以進一步降低反向轉(zhuǎn)移電容。

圖 3.p-GaN 屏蔽垂直 JFET 的掃描電子顯微鏡圖像。我們的仿真還表明,對于帶有 p-GaN 屏蔽的 VJFET,AlGaN 勢壘的厚度對常關(guān)作有很強的影響,并且導(dǎo)通電阻較低。
通過對該器件進行建模,我們確定了柵源電壓為 0 V 時導(dǎo)帶的輪廓和 2DEG 的密度。這項工作表明,在柵極區(qū)域,20 nm厚的Al實現(xiàn)了完全耗盡0.2加語0.8N 阻擋層。同時,在傾斜區(qū)域,一個 Al0.2加語0.880 nm厚的N勢壘能夠形成高密度的2DEG和低通道電阻。
我們的模擬的進一步發(fā)現(xiàn)表明,除了削減反向轉(zhuǎn)移電容外,我們在V型槽中的V形p-GaN屏蔽結(jié)構(gòu)還通過放松p-GaN阱邊緣的電場來抑制斷態(tài)漏電流,該電場存在干法蝕刻過程造成的損壞。這項工作還確定,由于p-GaN屏蔽結(jié)構(gòu)放松了電場,增加p-GaN阱底部和p-GaN屏蔽層底部之間的距離會降低p-GaN孔邊緣的電場強度。然而,這種好處是需要付出代價的:隨著 p-GaN 阱底部與 p-GaN 屏蔽層底部之間的距離延長,p-GaN 屏蔽層底部的電場強度增加。
基于這些發(fā)現(xiàn),我們得出結(jié)論,需要進行實驗研究來優(yōu)化對氮化鎵阱底部與對氮化鎵屏蔽層底部之間的距離,同時實現(xiàn)低關(guān)斷漏電流。
圖 4.這款 p-GaN 屏蔽垂直 JFET 專為大電流作而設(shè)計,芯片尺寸為 2.9 mm x 2.6 mm。
設(shè)備制造...
制造我們的新型 VJFET 首先將塊狀 GaN 襯底裝入 MOCVD 反應(yīng)器中,并沉積 7 μm 厚的硅摻雜 GaN 漂移層,載流子濃度為 1.3 x 1016厘米-3,然后是載流子濃度大于1.0 x 10的鎂摻雜p-GaN孔19厘米-3.使用這種異質(zhì)結(jié)構(gòu),阻斷電壓應(yīng)超過 900 V。
制造過程的后續(xù)步驟包括用電感耦合等離子體在外延片上蝕刻 V 形凹槽,并重新生長 Al0.2加語0.8N 和 GaN。我們改變了 Al 的厚度0.2加語0.8N 阻擋層從 50 nm 到 80 nm,并在柵極下方采用 20 nm 的三元厚度,通過電感耦合等離子體蝕刻進行部分去除來實現(xiàn)。
為了完成VJFET的制造,我們添加了p-GaN外延層,并選擇性地蝕刻它以形成柵極和p-屏蔽結(jié)構(gòu)。然后,我們對鋁進行了選擇性蝕刻0.2加語0.8N/GaN/p-GaN 孔形成源電極。最終器件在 GaN 襯底背面具有 Ti/Al 源電極、Pd/Au 柵極、p-GaN 屏蔽電極和 Ti/Al/Ti/Pt/Au 電極(制造過程概述見圖 2,我們設(shè)備的掃描電子顯微鏡圖像見圖 3)。

圖 5.p-GaN 屏蔽垂直 JFET 的導(dǎo)通狀態(tài)(左)和關(guān)閉狀態(tài)(右)直流輸出特性。
...和表征
我們的晶體管的電氣測量,其有效面積為 0.002 毫米2,顯示閾值電壓為 1.5 V。導(dǎo)通電阻隨勢壘層厚度的增加而減小,對于80 nm厚度,導(dǎo)通電阻和面積的乘積為1.23 mΩ cm2.漏源電壓范圍內(nèi)的關(guān)斷漏電流圖表明,當(dāng)p-GaN阱底部與p-GaN屏蔽層底部之間的距離為200 nm,而不是0 nm或400 nm時,泄漏要小得多。對于 200 nm 的距離,漏源電壓對漏電流影響很小,漏電流約為每平方厘米數(shù)十微安。

圖6.p-GaN 屏蔽可大幅降低反向傳輸電容。
我們還評估了一款專為大電流工作而設(shè)計的 2.9 mm x 2.6 mm p 屏蔽 VJFET(見圖 4)。該器件的最大漏極電流為 57 A,導(dǎo)通電阻為 58.6 mΩ,擊穿電壓為 972 V(見圖 5)。令人鼓舞的是,在漏源電壓為 500 V 時,反向傳輸電容僅為 2.92 pF,不到傳統(tǒng)同類產(chǎn)品值的八分之一(見圖 6)。此外,由于柵極面積減小,輸入電容更低。
我們的 p 屏蔽 VFJET 的一個關(guān)鍵品質(zhì)因數(shù)是其導(dǎo)通電阻和反向傳輸電容的乘積。該數(shù)字僅為 171 mΩ pF,低于市售 SiC MOSFET(見圖 7)。

圖7.使用數(shù)據(jù)手冊中提供的數(shù)據(jù),將松下 p-GaN 屏蔽垂直 JFET 與傳統(tǒng)同類產(chǎn)品和 650 V SiC MOSFET 進行基準測試。
我們
使用電感負載研究了 p 屏蔽 VJFET 在 400 V 和 20 A 下的開關(guān)性能。導(dǎo)通值為 14.3 V ns-1和 76.7 V ns-1分別用于我們的傳統(tǒng)和 p 屏蔽 VJFET。與傳統(tǒng)設(shè)備相比,導(dǎo)通損耗降低了 75%。
基于廣泛的結(jié)果組合,我們可以得出結(jié)論,我們的新型 VJFET 是服務(wù)于需要高功率和高速的應(yīng)用的有前途的候選者。




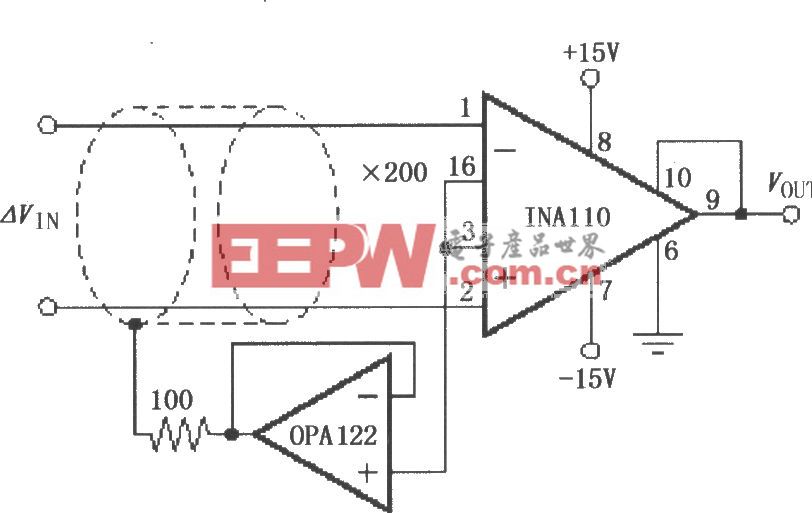



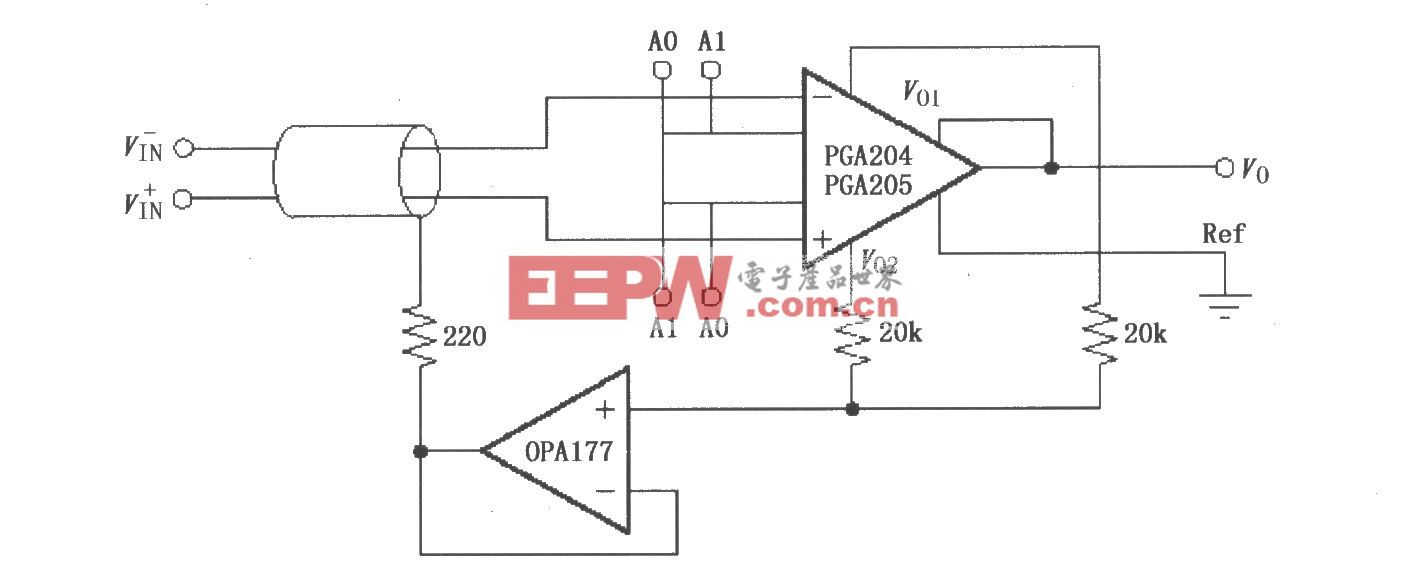



評論