如何準確估算IC結溫度
準確估算半導體器件的結溫度對于確保其可靠性、性能和壽命至關重要。結點溫度直接影響電子元件的效率、穩定性和安全性。
本文介紹了估算結口溫度的技術,重點是利用熱阻和熱表征參數。通過遵循這些技術,工程師可以實施有效的熱管理策略,提升設備性能,并降低過熱相關故障的風險。
此外,文章詳細介紹了基本的熱參數,強調了熱阻參數與熱表征參數之間的關鍵區別,并介紹了估算結溫的實用方法。同時還包括案例研究,以驗證這些方法的準確性。
理解熱阻和表征參數對于評估和比較電子封裝的熱性能至關重要。這些參數在有效的熱管理和準確的結溫度估計中起著關鍵作用。表1展示了五個主要熱參數的概述。

熱阻與熱表征參數
熱阻(θ)和熱表征(ψ)參數常被混淆,因為它們都涉及電子封裝的熱性能,并且涉及類似的散熱和溫差概念。然而,它們的作用不同,且在不同的條件下生成。
熱阻測量兩個點(例如接點到環境溫度,接點到機殼)除以功率耗散的溫度差,高度依賴于印刷電路板設計和氣流等具體條件。它通常考慮單一的主導熱流路徑,因此適合比較不同封裝的熱性能和設計冷卻方案。
熱特性參數測量結點與特定點(例如封裝頂部、板材頂部)之間的溫差除以功率耗散,考慮多種熱傳導路徑的綜合效應。這些參數對具體條件的依賴較小,在實際應用中提供了更準確的結溫估計。
例如,結到外殼(頂部)熱阻參數提取認為所有封裝損耗通過封裝頂部耗散,熱量通過單一主導路徑流動。參數通過模擬提取,因此在模擬中形成條件,強制所有熱量從頂部散發。在實際應用中不會發生這種情況,因為熱量會通過集成電路的不同路徑散發。
另一方面,結到外殼(頂部)熱表征參數是通過考慮IC中發生損耗時,只有部分熱量通過封裝頂部流出來的。它考慮了現實世界中所有可能的熱流路徑,使其更適合在實際應用中估算結口溫度。
圖1簡化了提取這兩個參數時熱流路徑差異的說明。請注意,此圖旨在簡化理解,未準確描繪實際的參數提取過程或封裝內部的熱流路徑。

1. 以θJC表示熱流路徑,ψJT參數提取。
這兩種指標之間的混淆源于它們都涉及溫度差和功率耗散,但它們在不同的情境下應用,且有明顯的依賴關系。理解這些差異對于準確的熱估計和管理至關重要。
結溫度估計技術
可以使用多種技術來估算封裝結溫度。使用正確的熱參數對于確保準確的溫度估計至關重要。以下是兩種主要方法,這些方法可以輕松應用于結溫度估計的實驗裝置。
方法1:利用結點到環境熱阻(θJA)
描述
這是一種無需專業設備即可大致估算接頭溫度的好方法。本質上,它提供了包內損失的概念。
要求
該封裝針對被測PCB的θJA值。
工作環境溫度和封裝內的準確損耗。
方程

挑戰
θJA值很大程度上取決于PCB設計和氣流,如果未正確考慮,可能導致精度不準確。
準確測量環境溫度和IC損耗也是關鍵方面。
方法2:使用接頭到外殼(頂部)熱特性分析(ψJT)
描述
該方法在估計結溫度方面很準確,但需要額外設備測量封裝殼體溫度。當封裝使用散熱片時,它無法用來估算結溫度。
要求
被測PCB封裝的ψ JT 值。
準確測量機殼頂部溫度和封裝功率耗散。
殼體溫度測量技術
兩種常用的封裝殼溫測量方法是:
使用熱成像相機:可以使用熱成像相機來觀察機殼溫度。該方法適用于室溫測量。準確測量依賴于熱成像相機的精度以及封裝損耗。
使用熱電偶:可以將熱電偶連接到包裝盒頂部以測量機殼溫度。該方法適用于所有溫度的測量,尤其是在需要將封裝放入熱室時。準確測量主要依賴于所使用的熱電偶和萬用表。
方程

挑戰
準確測量封裝殼體溫度對于精確估算接點溫度至關重要。
將熱電偶連接到包裝外殼頂部進行溫度測量可能具有挑戰性。
方法驗證:案例研究
本文討論的兩種方法通過bench驗證得到驗證。為了測試測量準確性,采用了MAX25255,該裝置配有溫度傳感器引腳,用于監測IC芯片結溫度。這為IC的實際結溫以及每種方法估算結溫的準確度提供了參考點。
JEDEC板和EV套件IC封裝的不同熱參數見表2。在我們的測試中,我們使用四層電動車MAX25255套件進行臺架驗證。

測試用例的作條件如下:
V輸入 = 12 V,V輸出 = 3.3 V,I輸出 = 8 A,fsw = 2,100 kHz,Tamb = 25°C
效率 = 92.3%,集成電路損耗 = 1.7 W
芯片結溫度(以溫度針測量)= 57.3°C
不同技術用于估算結溫度,以判斷它們與實際芯片溫度的匹配度。
情況1:使用 θJA
該方法無需專用設備計算封裝結溫度,從而降低了因設備校準錯誤導致測量誤差的可能性。只需將方程中不同參數相等即可計算結溫度。對于被測的集成電路,該方法的結溫估計如下方程3:

此處估算的結點溫度為56.45°C,接近溫度針所測得的實際結點溫度。測量誤差約為0.85°C(1.5%)。準確測量環境溫度和集成電路損耗對于最小化結溫度估計的誤差至關重要。例如,即使誤算IC損耗0.1瓦,結溫度也會變化1.85°C(3.3%)。
情況2:使用ψ JT配合熱成像相機進行殼體測量
該方法使用熱成像相機測量IC外殼的最高溫度。熱成像相機為E60BX,精度為±2°C或±2%(以較高者為準)。讓轉換器運行15到20分鐘,以確保IC結溫度穩定。IC捕獲的最大機殼溫度如圖2所示。

2. 用于MAX25255 IC外殼頂部溫度測量的熱成像。
熱成像相機測得的機殼溫度為56.1°C。 方程4用于計算結溫度:

此處估算的結點溫度為57.09°C,非常接近TEMP針所測得的實際結點溫度。測量誤差約為0.21°C——約0.37%,這是用于測量的熱成像相機精度誤差。準確估算機殼溫度比IC損耗計算更為關鍵。例如,即使IC損耗計算偏差0.5瓦,結溫度測量也會偏差0.29°C/W(0.5%)。這是使用ψ JT相較于θJA的一個主要優勢。
情況3:使用ψ JT配合熱電偶
與案例2相比,該方法使用熱電偶測量包裝殼溫度。需要根據應用規格選擇合適的熱電偶。此時選擇K型熱電偶,其精度為2.2°C或0.75%(以較高者為準)。
將熱電偶固定在封裝殼上至關重要,以確保測量準確——可以使用導熱膏或熱熱膠。確保導熱膏或膠水的溫度額定高于包裝測試所需的溫度。此時使用熱復合物TC3-1G。用導熱膏將熱電偶固定在IC頂部,以確保良好的熱接觸(見圖3)。

3. 使用熱解膏與MAX25255 IC外殼頂部的熱電偶連接。
熱電偶連接到一臺Fluke 52 II溫度計,其精度為±[0.05% + 0.3°C]。讓轉換器運行15到20分鐘,確保集成電路結溫度穩定,并測量溫度計的讀數。這次溫度計讀數為58°C。 方程5用于計算結溫度:

這里估算的接頭溫度是58.98°C,但準確度不如前兩種。測量誤差約為1.68°C——約2.93%。殼體溫度測量誤差增加的原因在于該技術中加入了相關設備(熱電偶、導熱膏和溫度計)。這仍然在不同設備測量精度的綜合范圍內。該技術的一個優點是,當封裝被放入熱室時,也可以用于估算結點溫度。
這三個案例研究驗證了所討論的封裝結溫度估計技術。雖然使用 θJA 可以不用專用設備就能大致估算,但 ψJT 能提供更準確的估計。與極限度依賴PCB設計的θJA相比,這些參數在實際應用中提供了更精確的結溫估計。
一個很好的例子是比較表2中JEDEC板和EV套件中MAX25255 θJA和ψJT的數值。注意,兩塊板子的θJA變化接近9°C/W,而ψ JT僅變化0.02°C/W。
總之,本文討論的技術可能無法絕對精確地測定包裝溫度。然而,只要深入了解熱度量并精心選擇估算技術,我們可以提高熱測量的準確性。



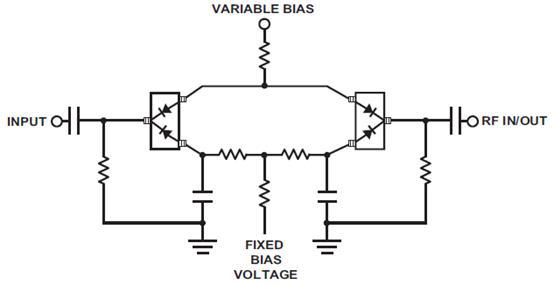





評論