封裝 文章 最新資訊
AMD 官宣 3D Chiplet 架構(gòu):可實(shí)現(xiàn)“3D 垂直緩存”

- 6 月 1 日消息 在今日召開的 2021 臺北國際電腦展(Computex 2021)上,AMD CEO 蘇姿豐發(fā)布了 3D Chiplet 架構(gòu),這項(xiàng)技術(shù)首先將應(yīng)用于實(shí)現(xiàn)“3D 垂直緩存”(3D Vertical Cache),將于今年年底前準(zhǔn)備采用該技術(shù)生產(chǎn)一些高端產(chǎn)品。蘇姿豐表示,3D Chiplet 是 AMD 與臺積電合作的成果,該架構(gòu)將 chiplet 封裝技術(shù)與芯片堆疊技術(shù)相結(jié)合,設(shè)計(jì)出了銳龍 5000 系處理器原型。官方展示了該架構(gòu)的原理,3D Chiplet 將一個 64MB 的 7n
- 關(guān)鍵字: AMD chiplet 封裝
英特爾對chiplet未來的一些看法
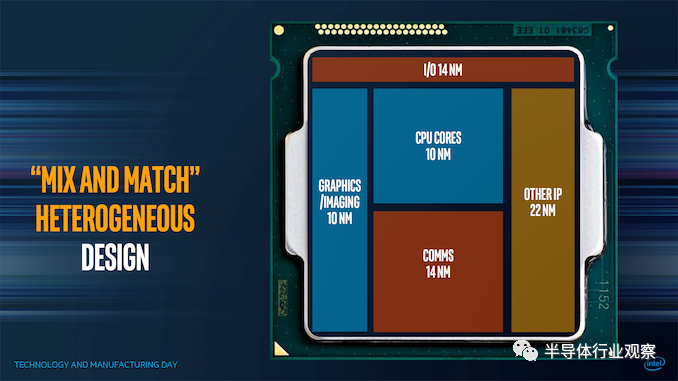
- 在英特爾2020年架構(gòu)日活動即將結(jié)束的時候,英特爾花了幾分鐘時間討論它認(rèn)為某些產(chǎn)品的未來。英特爾客戶計(jì)算部門副總裁兼首席技術(shù)官Brijesh Tripathi提出了對2024年以上未來客戶端產(chǎn)品前景的展望。他表示,他們將以英特爾的7+制造工藝為中心,目標(biāo)是啟用“Client 2.0”,這是一種通過更優(yōu)化的芯片開發(fā)策略來交付和實(shí)現(xiàn)沉浸式體驗(yàn)的新方法。Chiplet(小芯片)并不是新事物,特別是隨著英特爾競爭對手最近發(fā)布的芯片,并且隨著我們進(jìn)入更復(fù)雜的過程節(jié)點(diǎn)開發(fā),小芯片時代可以使芯片上市時間更快,給定產(chǎn)品的
- 關(guān)鍵字: 英特爾 chiplet 封裝
三星圖像傳感器計(jì)劃采用CSP封裝技術(shù) 以降低成本

- 據(jù)國外媒體報(bào)道,三星電子計(jì)劃采用一種新的封裝技術(shù),以降低圖像傳感器的成本。從外媒的報(bào)道來看,三星圖像傳感器計(jì)劃采用的是芯片級封裝(Chip Scale Package,CSP)技術(shù),從明年開始采用,不過只會用于低分辨率的圖像傳感器。COB封裝技術(shù)據(jù)The Elec報(bào)道,目前三星電子的圖像傳感器采用板上芯片封裝(Chips on Board,COB) ——?COB是當(dāng)前圖像傳感器最常用的封裝方法,即將圖像傳感器放置在PCB上,并通過導(dǎo)線連接,再將鏡頭附著在上面。然而,該過程需要一個潔凈室,因?yàn)樵诜?/li>
- 關(guān)鍵字: 三星 圖像傳感器 CSP 封裝
長電科技上半年延續(xù)高增長 大力布局先進(jìn)封裝功不可沒
- 5G通信與新能源汽車引領(lǐng)的新一輪科技迭代浪潮,將全球半導(dǎo)體行業(yè)引入了新一輪景氣周期。面對強(qiáng)勁市場需求,包括封測在內(nèi)的行業(yè)相關(guān)企業(yè)普遍迎來業(yè)績利好。日前,國內(nèi)封測龍頭長電科技(股票代碼600584)發(fā)布了截至2021年6月30日的半年度財(cái)務(wù)報(bào)告。財(cái)報(bào)顯示,長電科技上半年實(shí)現(xiàn)營收人民幣138.2億元,同比增長15.4%。凈利潤為人民幣13.2億元,同比增長261.0%,創(chuàng)歷年上半年凈利潤新高。自2020年起,長電科技進(jìn)入增長快車道,去年全年凈利潤達(dá)到13億元。進(jìn)入2021年,長電科技的業(yè)績增速勢頭不減,上半年
- 關(guān)鍵字: 封裝 先進(jìn)
三星加快部署3D芯片封裝技術(shù) 希望明年同臺積電展開競爭

- 據(jù)國外媒體報(bào)道,本月中旬,三星展示了他們的3D芯片封裝技術(shù),而外媒最新的報(bào)道顯示,三星已加快了這一技術(shù)的部署。外媒是援引行業(yè)觀察人士透露的消息,報(bào)道三星在加快3D芯片封裝技術(shù)的部署的。加快部署,是因?yàn)槿菍で竺髂觊_始同臺積電在先進(jìn)芯片的封裝方面展開競爭。從外媒的報(bào)道來看,三星的3D芯片封裝技術(shù)名為“eXtended-Cube” ,簡稱“X-Cube”,是在本月中旬展示的,已經(jīng)能用于7nm制程工藝。三星的3D芯片封裝技術(shù),是一種利用垂直電氣連接而不是電線的封裝解決方案,允許多層超薄疊加,利用直通硅通孔技術(shù)來
- 關(guān)鍵字: 三星 3D 芯片 封裝 臺積電
Intel宣布全新混合結(jié)合封裝:凸點(diǎn)密度猛增25倍

- 在Intel的六大技術(shù)支柱中,封裝技術(shù)和制程工藝并列,是基礎(chǔ)中的基礎(chǔ),這兩年Intel也不斷展示自己的各種先進(jìn)封裝技術(shù),包括Foveros、Co-EMIB、ODI、MDIO等等。Intel又宣布了全新的“混合結(jié)合”(Hybrid Bonding),可取代當(dāng)今大多數(shù)封裝技術(shù)中使用的“熱壓結(jié)合”(thermocompression bonding)。據(jù)介紹,混合結(jié)合技術(shù)能夠加速實(shí)現(xiàn)10微米及以下的凸點(diǎn)間距(Pitch),提供更高的互連密度、更小更簡單的電路、更大的帶寬、更低的電容、更低的功耗(每比特不到0.0
- 關(guān)鍵字: Intel 封裝 凸點(diǎn)密度
三星電子展示3D晶圓封裝技術(shù) 可用于5納米和7納米制程
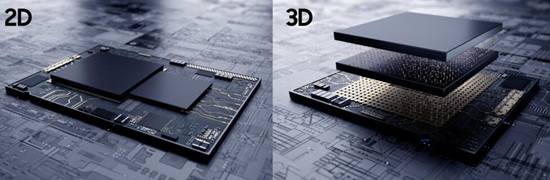
- 據(jù)臺灣媒體報(bào)道,三星電子成功研發(fā)3D晶圓封裝技術(shù)“X-Cube”,稱這種垂直堆疊的封裝方法,可用于7納米制程,能提高該公司晶圓代工能力。圖片來自三星電子官方三星的3D IC封裝技術(shù)X-Cube,采用硅穿孔科技(through-silicon Via、簡稱TSV),能讓速度和能源效益大幅提升,以協(xié)助解決次世代應(yīng)用嚴(yán)苛的表現(xiàn)需求,如5G、人工智能(AI)、高效能運(yùn)算、行動和穿戴設(shè)備等。三星晶圓代工市場策略的資深副總裁Moonsoo Kang表示,三星的新3D整合技術(shù),確保TSV在先進(jìn)的極紫外光(EUV)制程節(jié)
- 關(guān)鍵字: 三星 3D 晶圓 封裝
集成濾光窗的MEMS紅外傳感器電子封裝

- 摘要傳感器半導(dǎo)體技術(shù)的開發(fā)成果日益成為提高傳感器集成度的一個典型途徑,在很多情況下,為特殊用途的MEMS(微機(jī)電系統(tǒng))類傳感器提高集成度的奠定了堅(jiān)實(shí)的基礎(chǔ)。本文介紹一個MEMS光熱傳感器的封裝結(jié)構(gòu)以及系統(tǒng)級封裝(SIP)的組裝細(xì)節(jié),涉及一個基于半導(dǎo)體技術(shù)的紅外傳感器結(jié)構(gòu)。傳感器封裝以及其與傳感器芯片的物理交互作用,是影響系統(tǒng)整體性能的主要因素之一,本文將重點(diǎn)介紹這些物理要素。本文探討的封裝結(jié)構(gòu)是一個腔體柵格陣列(LGA)。所涉及材料的結(jié)構(gòu)特性和物理特性必須與傳感器的光學(xué)信號處理和內(nèi)置專用集成電路(ASIC
- 關(guān)鍵字: 紅外傳感器 封裝 光窗 紅外濾光片 MEMS
盛美半導(dǎo)體首臺無應(yīng)力拋光設(shè)備交付中國晶圓級先進(jìn)封裝龍頭企業(yè)客戶
- 盛美半導(dǎo)體設(shè)備公司,作為國際領(lǐng)先的半導(dǎo)體和晶圓級封裝設(shè)備供應(yīng)商,近日發(fā)布公司新產(chǎn)品:適用于晶圓級先進(jìn)封裝應(yīng)用(Wafer Level Advance Package)的無應(yīng)力拋光(Stree-Free-Polish)解決方案。先進(jìn)封裝級無應(yīng)力拋光(Ultra SFP ap)設(shè)計(jì)用于解決先進(jìn)封裝中,硅通孔(TSV)和扇出(FOWLP)應(yīng)用金屬平坦化工藝中表層銅層過厚引起晶圓翹曲的問題。
- 關(guān)鍵字: 盛美半導(dǎo)體 晶圓 封裝
Manz亞智科技推進(jìn)國內(nèi)首個大板級扇出型封裝示范工藝線建設(shè)
- 全球領(lǐng)先的高科技設(shè)備制造商Manz亞智科技,交付大板級扇出型封裝解決方案于廣東佛智芯微電子技術(shù)研究有限公司(簡稱佛智芯),推進(jìn)國內(nèi)首個大板級扇出型封裝示范線建設(shè),是佛智芯成立工藝開發(fā)中心至關(guān)重要的一個環(huán)節(jié),同時也為板級扇出型封裝裝備奠定了驗(yàn)證基礎(chǔ),從而推進(jìn)整個扇出型封裝(FOPLP)行業(yè)的產(chǎn)業(yè)化發(fā)展。5G、云端、人工智能等技術(shù)的深入發(fā)展,使其廣泛應(yīng)用于移動裝置、車載、醫(yī)療等行業(yè),并已成為全球科技巨擘下一階段的重點(diǎn)發(fā)展方向。而在此過程中,體積小、運(yùn)算及效能更強(qiáng)大的芯片成為新的發(fā)展趨勢和市場需求,不僅如此,芯
- 關(guān)鍵字: 封裝 FOPLP
Intel全球首秀一體封裝光學(xué)以太網(wǎng)交換機(jī)
- Intel近日宣布,已成功將1.6Tbps的硅光引擎與12.8Tbps的可編程以太網(wǎng)交換機(jī)成功集成在一起。這款一體封裝解決方案整合了Intel及旗下Barefoot Networks部門的基礎(chǔ)技術(shù)構(gòu)造模塊,可用于以太網(wǎng)交換機(jī)上的集成光學(xué)器件。
- 關(guān)鍵字: Intel 以太網(wǎng)交換機(jī) 封裝
儒卓力提供具有高功率密度的威世N-Channel MOSFET
- 威世的SiSS12DN 40V N-Channel MOSFET是為提高功率轉(zhuǎn)換拓?fù)渲械墓β拭芏群托识O(shè)計(jì)。它們采用3.3x3.3mm緊湊型PowerPAK 1212-8S封裝,可提供低于2mΩ級別中的最低輸出電容(Coss)。
- 關(guān)鍵字: 儒卓力 威世N-Channel MOSFET 封裝
更小36V、4A電源模塊將解決方案尺寸減小30%
- 德州儀器(TI)近日推出了業(yè)界更小的采用四方扁平無引線封裝(QFN)的36V、4A電源模塊。TPSM53604?DC/DC降壓模塊5mm x 5.5mm的面積使工程師能夠?qū)⑵潆娫闯叽缈s小30%,同時將功率損耗減少到其他同類模塊的50%。新電源模塊配有一個導(dǎo)熱墊來優(yōu)化熱傳遞,使工程師能夠簡化電路板安裝和布局。如需了解更多信息、樣品和評估模塊,敬請?jiān)L問?http://www.ti.com.cn/product/cn/TPSM53604。TPSM53604可在高達(dá)105°C的環(huán)境溫度下運(yùn)行,
- 關(guān)鍵字: 新模塊 封裝
封裝介紹
程序 封裝 (encapsulation)
隱藏對象的屬性和實(shí)現(xiàn)細(xì)節(jié),僅對外公開接口,控制在程序中屬性的讀和修改的訪問級別.
封裝 (encapsulation)
封裝就是將抽象得到的數(shù)據(jù)和行為(或功能)相結(jié)合,形成一個有機(jī)的整體,也就是將數(shù)據(jù)與操作數(shù)據(jù)的源代碼進(jìn)行有機(jī)的結(jié)合,形成“類”,其中數(shù)據(jù)和函數(shù)都是類的成員。
封裝的目的是增強(qiáng)安全性和簡化編程,使用者不必了解具體的 [ 查看詳細(xì) ]
關(guān)于我們 -
廣告服務(wù) -
企業(yè)會員服務(wù) -
網(wǎng)站地圖 -
聯(lián)系我們 -
征稿 -
友情鏈接 -
手機(jī)EEPW
Copyright ?2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《電子產(chǎn)品世界》雜志社 版權(quán)所有 北京東曉國際技術(shù)信息咨詢有限公司
 京ICP備12027778號-2 北京市公安局備案:1101082052 京公網(wǎng)安備11010802012473
京ICP備12027778號-2 北京市公安局備案:1101082052 京公網(wǎng)安備11010802012473
Copyright ?2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《電子產(chǎn)品世界》雜志社 版權(quán)所有 北京東曉國際技術(shù)信息咨詢有限公司







