Onsemi EliteSiC 基于高電壓熱插拔應(yīng)用
安森美(onsemi)的碳化硅(SiC)系列產(chǎn)品“EliteSiC”可以為能源基礎(chǔ)設(shè)施和工業(yè)驅(qū)動應(yīng)用提供高能效、高可靠性的解決方案。1700 V EliteSiC MOSFET具有更高的擊穿電壓(BV),最大Vgs范圍為-15 V/25 V,適用于快速開關(guān)應(yīng)用,其柵極電荷(Qg)在1200 V、40 A條件下僅為200 nC,遠(yuǎn)低于同類競爭產(chǎn)品。兩款肖特基二極管在1700 V額定擊穿電壓下,具有出色的反向漏電流性能,最大反向電流(IR)在25°C時為40 μA,175°C時為100 μA,顯著優(yōu)于競爭對手。
新的1700 V EliteSiC器件針對可再生能源應(yīng)用中向更高電壓發(fā)展的趨勢,如太陽能系統(tǒng)從1100 V向1500 V直流母線升級,提供了更高的擊穿電壓(BV)值,滿足快速開關(guān)和高功率應(yīng)用的需求。此外,安森美還關(guān)注熱插拔控制器的設(shè)計需求,特別是在高電壓(400 V至800 V)系統(tǒng)中,如數(shù)據(jù)中心用于AI計算等場景,需要合適的解決方案來實現(xiàn)安全的熱插拔功能,避免高涌入電流對系統(tǒng)造成損壞。

圖1. 簡化框圖
本應(yīng)用說明將重點介紹onsemi EliteSiC組合JFET用于熱插拔應(yīng)用,包括優(yōu)勢、工作模式描述、設(shè)計實踐和測試結(jié)果等。
1. 產(chǎn)品介紹
EliteSiC JFET 基于設(shè)備JFET是最簡單的場效應(yīng)晶體管(FET)設(shè)備,具有直接的漏極到源極電流路徑。這種簡單的結(jié)構(gòu)提供了最低的導(dǎo)通電阻,并且沒有影響可靠性的柵極電荷陷阱或表面電流。圖2顯示了JFET的結(jié)構(gòu)。JFET是一個常開設(shè)備,這意味著在沒有施加負(fù)柵極偏置的情況下,設(shè)備是開啟的。要切換或保持其關(guān)閉,需要施加負(fù)電壓(低于其閾值電壓)。

圖2. JFET結(jié)構(gòu)(左:結(jié)構(gòu),右:符號)
onsemi提供兩種基于SiC JFET的常關(guān)設(shè)備類型:
? CJFET(級聯(lián)JFET),碳化硅(SiC)JFET
? Combo JFET,碳化硅(SiC)組合JFET
CJFET利用低電壓MOSFET和JFET的級聯(lián)配置。MOSFET作為JFET源的開關(guān),而JFET的柵極連接到MOSFET的源。該配置的電路圖和符號可以在圖3中找到。

圖3. CJFET結(jié)構(gòu)
當(dāng)?shù)碗妷篗OSFET的柵源電壓(VGS)高于其閾值電壓時,MOSFET開啟。當(dāng)JFET源連接到MOSFET漏極且其柵極連接到MOSFET源時,由于VGS_JFET超過其閾值,JFET被開啟。相反,當(dāng)MOSFET的VGS較低(且處于關(guān)閉狀態(tài))時,施加在CJFET上的外部電壓將增加MOSFET的VDS,直到超過JFET的閾值電壓,從而關(guān)閉JFET并使CJFET能夠阻擋高電壓。CJFET主要用于高頻開關(guān)模式應(yīng)用。
Combo JFET與CJFET的級聯(lián)配置相似,但有一個關(guān)鍵區(qū)別,即JFET的柵極可以外部訪問。對JFET柵極的外部訪問提供了幾個優(yōu)點,包括:? 通過過驅(qū)動降低導(dǎo)通電阻? 增加線性模式控制的穩(wěn)定性? 可調(diào)的開關(guān)速度以減少過沖并便于并聯(lián)? 監(jiān)測結(jié)溫的能力
對于熱插拔等電路保護(hù)應(yīng)用,線性模式穩(wěn)定性和可調(diào)開關(guān)速度至關(guān)重要。這就是為什么推薦Combo JFET用于熱插拔應(yīng)用。圖4顯示了Combo JFET的符號。

圖4. Combo JFET符號
詳細(xì)信息請參見UM70113 - JFET和Combo JFET用戶指南
Combo JFET在熱插拔應(yīng)用中的優(yōu)點:低導(dǎo)通電阻Rds(on)在正常操作期間最小化電壓降和功耗,當(dāng)功率FET完全開啟時。基于JFET的設(shè)備具有比MOSFET設(shè)備更低的Rsp,下面的圖顯示了不同技術(shù)之間的原因和測試的RdsA。

圖5. JFET和MOSFET之間的結(jié)構(gòu)和RdsA比較
2. 強(qiáng)安全操作區(qū)域 (SOA)
在熱插拔過程中,功率FET兩端的電壓最初完全是直流鏈接總線電壓,并在直流鏈接電容器完全充電時降至零電壓。為了保持功率FET的結(jié)溫在規(guī)格范圍內(nèi),充電電流通常相對于其正常工作電流非常低。這種操作可能會導(dǎo)致現(xiàn)代功率FET的熱不穩(wěn)定性問題。熱穩(wěn)定性由轉(zhuǎn)移曲線上正溫度系數(shù)區(qū)域的大小來定義。下圖顯示了1200 V/7 m JFET和MOSFET的轉(zhuǎn)移曲線示例。明顯可以看出,SiC JFET的PTC區(qū)域相對小于SiC MOSFET。

圖6. SiC JFET和SiC MOSFET的轉(zhuǎn)移曲線
電流限制:熱插拔功率FET需要限制電流以確保系統(tǒng)和自身的安全。熱插拔應(yīng)用有兩種電流限制場景:啟動(直流鏈接電容器預(yù)充電)和過流保護(hù)(OCP)。圖7顯示了啟動和OCP電流限制的工作條件。

圖7. 啟動涌入電流和過流保護(hù)
Combo JFETs 可以在電流限制(線性模式)穩(wěn)定性下工作,它們已與熱插拔控制器在 400 V 和 800 V 系統(tǒng)中進(jìn)行了測試。圖 8 說明了 Combo JFETs 在啟動和過流保護(hù)(OCP)期間的線性模式操作的工作原理。

圖 8. Combo JFET 啟動和 OCP 期間的工作原理
門驅(qū)動電壓兼容性:大多數(shù)熱插拔控制器的門偏置電壓在 10 V 到 12 V 之間,功率半導(dǎo)體的門驅(qū)動電壓需要與熱插拔控制器兼容。由于低電壓硅 MOSFET 門輸入,Combo JFET 與所有熱插拔控制器具有通用的門兼容性。圖 9 顯示 10 V ? 15 V 的門電壓可以使 Combo JFET 完全導(dǎo)通。

圖 9. Combo JFET 不同門電壓下的典型輸出 V/I 曲線(1200 V/9 m 設(shè)備示例)
3.熱插拔控制方法
熱插拔控制器感測電流輸出和輸入/輸出電壓以進(jìn)行控制,請參考控制器以獲取詳細(xì)信息。在本應(yīng)用說明中,我們將討論涌入控制方法,因為涌入或啟動階段對功率器件的壓力更大。限制涌入電流有兩種典型方法,一種是 dv/dt 控制/模式,另一種是主動電流限制。
帶外部 Cgd 的 dv/dt 控制
恒定輸出電壓斜率(dv/dt)可以控制涌入電流值,限制的電流水平由以下公式定義:

功率 FET 的 dv/dt 在門到源電壓處于閾值水平時由恒定的門驅(qū)動電流控制。
這恒定柵極驅(qū)動電流控制功率FET dv/dt 通過 Cgd,遵循:

基于 (公式 1) 和 (公式 2) 突入電流定義為公式 3。

熱插拔控制器在 5 μA – 20 μA 水平提供恒定柵極驅(qū)動電流。外部 Cgd 可能是必要的,以保持突入電流在不同負(fù)載電容水平下處于功率 FET SOA 內(nèi)。離散解決方案如圖 10 所示,模擬結(jié)果如圖 11 所示。此處演示了級聯(lián)結(jié)構(gòu),Q1 是 SiC JFET,Q2 是低壓 MOSFET。onsemi 提供單獨的 JFET 和 LV MOSFET,或組合 JFET,將兩個芯片封裝在一個包中。

圖 10. 離散 dv/dt 控制原理圖

圖 11. dv/dt 控制仿真結(jié)果
連續(xù)電流閉環(huán)模式:控制器感測負(fù)載電流此感測電流反饋到恒定電流控制環(huán)路,并與電流設(shè)定值進(jìn)行比較。感測電流與設(shè)定電流值之間的差異被放大以驅(qū)動功率 FET 柵極。在 JFET 的漏極和 LV MOSFET 的柵極之間仍然需要一定水平的外部 Cgd 以穩(wěn)定控制。離散設(shè)計如圖 12 所示,以展示電流閉環(huán)控制的原理。

圖12. 電流閉環(huán)控制框圖
不連續(xù)電流閉環(huán)模式:電流閉環(huán)控制需要足夠的電流感應(yīng)分辨率以準(zhǔn)確控制電流,因此存在最小可控電流水平。如果最小可控電流水平高于SOA能力,則可以使用不連續(xù)模式(升壓模式)方法。不連續(xù)模式意味著電流處于最小可控水平,具有一定的脈沖長度(在SOA范圍內(nèi)),并在兩個主動電流脈沖之間有一定的冷卻時間。該方法平衡了電流控制分辨率和SOA限制。
4.設(shè)計實踐
熱能力:保持結(jié)溫在規(guī)范范圍內(nèi)的最大允許功率損耗由熱阻抗和環(huán)境溫度決定(公式4)。

公式4中的ZJA是從器件結(jié)到環(huán)境的阻抗。熱堆棧如圖13所示。從結(jié)到外殼的熱阻抗(ZJC)被表征并在數(shù)據(jù)表中以不同脈沖持續(xù)時間的曲線顯示。從外殼到環(huán)境的熱阻抗(ZCA)應(yīng)由應(yīng)用設(shè)計師進(jìn)行表征。

圖13. 熱阻抗
RC熱模型(Foster或Cauer)是功率FET熱阻抗的等效表示,以支持在SPICE模擬器中使用的計算或仿真。Foster模型適用于SiC組合JFET。圖14顯示了熱瞬態(tài)曲線和Foster RC網(wǎng)絡(luò)。

圖14. UG4SC075009K4S熱阻抗
圖15指示了包括外殼到環(huán)境的熱模型的結(jié)溫仿真。Ploss是模擬器中的電流源,表示功率FET的瞬時功率損耗,TA是表示環(huán)境溫度的電壓源。

圖15. 熱模型(Foster)
案例到環(huán)境熱阻和電容影響結(jié)點溫度,進(jìn)行SPICE仿真以顯示基于UG4SC075009K4S和表1中的條件。

表1
仿真(圖16)顯示在特定的案例到環(huán)境熱阻抗(Rth_CA = 5 K/W和Cth_CA = 0.1 Ws/K)下,基于UG4SC075009K4S的啟動電流限制操作期間的結(jié)點溫度。

圖16. 結(jié)點溫度仿真結(jié)果
圖17顯示了不同案例到環(huán)境熱阻和電容的仿真結(jié)果。從這些仿真結(jié)果來看,當(dāng)熱電容足夠高(>0.2 Ws/K)時,熱阻的容忍度很高(從5 K/W到20 K/W)在啟動期間。

圖17. 不同案例到環(huán)境熱阻抗的Tj仿真結(jié)果
散熱器的熱阻由給定設(shè)計的氣流決定,熱電容可以用(公式5)計算:

熱界面材料(TIM)被視為Z CA的一部分,實際熱阻抗應(yīng)通過測試測量。
熱穩(wěn)定性:功率FET的SOA曲線可能顯示不同脈沖寬度和外殼溫度下的理想化漏源電壓(VDS)和漏電流(ID)曲線。

圖18. SOA曲線 ? 恒定功率線
當(dāng)功率FET導(dǎo)通時,基本上有兩種不同的操作模式:
? 歐姆區(qū):VDS 值遵循ID x Rds(on)的規(guī)則
? 線性模式區(qū):VDS 值與ID 無關(guān),VDS 由外部電路決定,ID 由VGS 控制(ID = k(VGS ? VTH ) 2 )
與相同的電流水平,當(dāng)功率器件在線性模式下工作時,其功率損耗顯著高于在歐姆模式下工作時。用于浪涌電流限制的功率FET將相對較長時間進(jìn)入線性模式,與其熱瞬態(tài)時間相比。這就是為什么預(yù)充電電流通常較小,必須根據(jù)環(huán)境和熱能力在安全工作區(qū)(SOA)內(nèi),特別是之前討論的熱電容。然而,實際部件在高VDS區(qū)域可能表現(xiàn)出不同的行為,實際SOA上的電流與恒定功率線相比更小。這種現(xiàn)象被稱為“Spirito效應(yīng)”,是由于局部熱點的形成。功率FET的轉(zhuǎn)移曲線顯示了在給定結(jié)溫和漏源電壓(VDS)下,漏電流(ID)作為柵源電壓(VGS)的函數(shù)。圖18顯示了onsemi第四代SiC JFET的典型轉(zhuǎn)移曲線。在不同結(jié)溫下,兩條曲線之間存在交叉點。在這個點上,當(dāng)結(jié)溫變化時,漏電流不會改變,這意味著溫度系數(shù)為零(ZTC)。在這個點以下,由于結(jié)溫升高,漏電流變得更高,可能會形成熱點。芯片上的更熱區(qū)域集中更多電流,導(dǎo)致進(jìn)一步加熱,并可能因局部區(qū)域的熱失控而失效。AND90317 - SiC JFET在主動模式應(yīng)用中顯示了基于轉(zhuǎn)移曲線和熱瞬態(tài)的穩(wěn)定性分析方法。

圖19. SiC JFET轉(zhuǎn)移曲線
當(dāng)功率損耗增加超過功率可以熱散失的能力時,就會發(fā)生熱失控。
? P_loss(t) / ? T_J(t) ≥ ? P(t) / ? T_J(t) (公式6)
其中 P_loss(t) = I_D(t) * V_DS(t) 和 ? T_J(t) = ? P(t) / Z(t),熱穩(wěn)定性的條件可以表示為:
? I_D(t) / ? T_J(t) ≥ 1 / Z(t) * V_DS(t) (公式7)
對于熱插拔應(yīng)用,所有參數(shù)都會變化,包括不同的結(jié)溫、時間或電壓。因此,通過測試實際設(shè)計進(jìn)行驗證比基于公式6和7的理論分析更可靠。
測試結(jié)果
組合JFET(UG4SC075011K4S)在熱插拔控制器下測試,用于將330μF電容器充電至400V,充電電流為160mA,完全充電的時間為800毫秒。

圖20. 熱插拔啟動測試結(jié)果




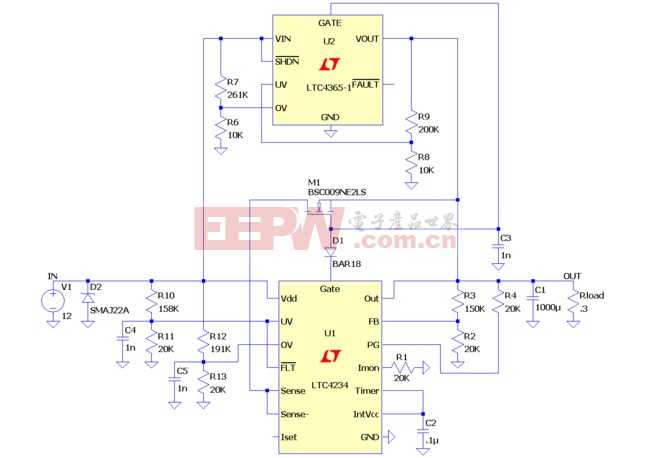








評論