T2PAK封裝應用筆記:封裝結構詳解
T2PAK應用筆記重點介紹T2PAK封裝的貼裝及其熱性能的高效利用。內容涵蓋以下方面:T2PAK封裝詳解:全面說明封裝結構與關鍵規格參數;焊接注意事項:闡述實現可靠電氣連接的關鍵焊接注意事項;濕度敏感等級(MSL)要求:明確器件在處理與存儲過程中的防潮防護規范;器件貼裝指南:提供器件貼裝的最佳實踐建議。本文為第一篇,將介紹頂部散熱封裝、T2PAK封裝詳解。
安森美(onsemi)為強化其先進封裝的電源產品組合,推出了兩款面向汽車與工業高壓(HV)應用的頂部散熱封裝——T2PAK 和 BPAK。這兩款封裝專為應對嚴苛工況而設計,與通過印刷電路板(PCB)散熱的傳統底部散熱封裝(如 D2PAK 和 TOLL)不同,T2PAK 與 BPAK 采用頂部散熱結構,通過直接接觸外部散熱器實現高效熱傳導,顯著提升散熱性能。
其中,T2PAK 憑借頂部散熱與無引線設計的雙重優勢,不僅消除了傳統長引線,還構建出比 D2PAK 或 TO 封裝更緊湊的電流回路,從而大幅降低雜散電感。這一優化帶來了更優異的開關特性、更低的電壓過沖以及更出色的電磁兼容性(EMC),使其成為高效率、高密度電源設計的理想選擇。
此次技術突破有效提升了功率密度,更好地滿足了高性能應用日益增長的需求。安森美首批采用該新型封裝的產品包括八款基于 Elite-SiC 平臺的碳化硅(SiC)MOSFET。



圖1. T2PAK封裝視圖
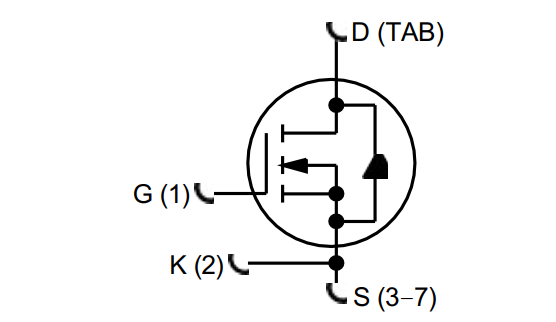
T2PAK封裝輪廓詳見圖3所示。其中,圖3a與圖3b分別為封裝頂視圖與側視圖;細節A進一步展示了引腳尺寸,對應側視圖(圖3c)、正視圖(圖3d)與后視圖(圖3e);底視圖見圖3f。所有相關尺寸標注于圖3g和圖3h。封裝主體尺寸約為11.80 mm × 14.00 mm × 3.63 mm(D×E×A),含引腳的整體平面尺寸為18.50 mm × 14 mm(H×H1)。

T2PAK與D2PAK(TO-263)均為高功率表面貼裝封裝,適用于緊湊型PCB布局下的高效熱管理。二者電氣焊盤占位相似,但熱結構設計存在明顯區別:D2PAK采用底部散熱,依靠外露漏極焊盤將熱量傳導至PCB銅層,并通過過孔傳導至內部或背面的銅層;而T2PAK則通過集成通孔散熱引腳實現頂部散熱,可直接連接外部散熱器或金屬外殼。這種設計提供了更高效、可控的散熱機制,尤其適合PCB自身散熱受限或具備強制風冷的應用場景。
上述結構差異帶來了可量化的熱性能提升。以32 mΩ器件為例,T2PAK的結殼熱阻為0.7 °C/W,優于D2PAK的0.75 °C/W。在12 mΩ這類低阻值、高電流器件中,優勢更為明顯:T2PAK熱阻為0.3 °C/W,而對應D2PAK為0.35 °C/W。這主要得益于T2PAK可將熱量直接導向散熱器,從而突破PCB的散熱瓶頸。因此,該封裝尤其適用于對散熱要求嚴苛或需更高熱裕量的場合,如汽車功率模塊、工業驅動器及高效率DC-DC轉換器。
圖5所示為T2PAK推薦的PCB焊盤布局。在封裝頂視圖中,引腳定義如下:右下角為引腳1(柵極),引腳2為開爾文源極(用于驅動參考電位),引腳3至7為源極連接。漏極則通過延伸的大型漏極焊片實現電氣連接,該焊片與封裝頂部中央的外露漏極焊盤相連,共同構成主散熱區域。


未完待續。














評論