SK海力士探索高帶寬存儲堆疊 NAND 和 DRAM
報告援引消息人士解釋說,SK海力士正在將低功耗寬I/O DRAM與NAND堆疊在一起,以創建HBS,它可以堆疊多達16層DRAM和NAND。根據 ETNews 的說法,這些層通過垂直線扇出 (VFO) 互連,顯著提高了數據處理速度。
值得注意的是,這并不是SK海力士首次使用VFO。ETNews 報道稱,該公司此前為蘋果 Vision Pro 提供了采用垂直線扇出技術封裝的 DRAM,而新的 HBS 通過集成 NAND 進一步推動了這一概念。
據SK海力士稱,2023年首次亮相的VFO是一種通過垂直連接電線而不是彎曲電線來最大限度地減少空間并降低功耗的技術。它還徹底改變了大型扇出晶圓級封裝 (WLP),這是一種將 I/O 端子與芯片外部電線連接起來的封裝技術。
SK海力士聲稱其垂直扇出設計帶來了顯著的收益:與傳統設計相比,電線長度減少了4.6倍,從而將電源效率提高了4.9%。該公司指出,除此之外,該技術還降低了 27% 的包裝高度,并將散熱提高了 1.4%。
報告指出,值得注意的是,與 HBM 不同,HBS 不需要穿透芯片的硅通孔 (TSV) 工藝,從而使其具有更高的良率和更低的制造成本。
潛在應用/HBF 路線圖
展望未來,ETNews 指出,DRAM 和 NAND 堆疊的 HBS 與應用處理器 (AP) 一起封裝,并直接集成到移動設備中。因此,該報告表明,SK海力士開發HBS是為了滿足智能手機、平板電腦和其他移動平臺對增強人工智能性能不斷增長的需求。
SK海力士的最新舉措與其早些時候的專利申請相一致。據 Sisa Journal 3 月份報道,該公司于 2 月份向韓國知識產權局 (KIPO) 申請了“LPW NAND”商標,該技術被認為反映了 SanDisk 的高帶寬閃存 (HBF)。報告指出,SanDisk 的第一代 HBF 堆疊 16 層,達到 512GB,提供類似 HBM 的帶寬,同時將容量擴展 8-16 倍。
展望未來,根據 Wccftech 引用的路線圖,SK 海力士的 HBF 產品預計將于 2029 年至 2031 年之間上市。












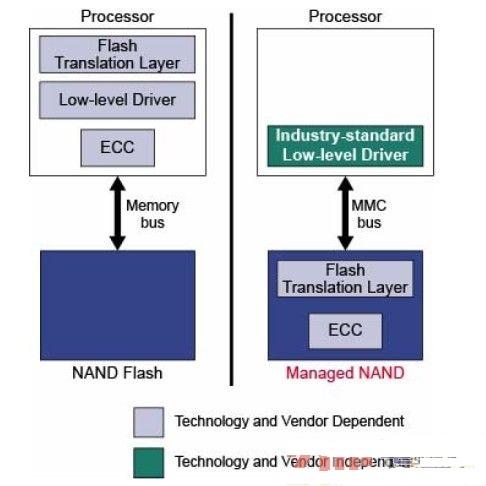
評論