有望改變 AI 半導體規則,消息稱三星電子年內將推出 HBM 三維封裝技術 SAINT-D
IT之家 6 月 18 日消息,據韓媒《韓國經濟日報》報道,三星電子將于年內推出可將 HBM 內存與處理器芯片 3D 集成的 SAINT-D 技術。
本文引用地址:http://cqxgywz.com/article/202406/459985.htm報道同時指出,在今年發布后,三星有望于明年推出的 HBM4 內存中正式應用 SAINT(IT之家注:即 Samsung Advanced INterconnect Technology 的簡寫)-D 技術。
SAINT-D 是三星電子的一項 3DIC 先進封裝技術,旨在垂直集成邏輯裸片和 DRAM 內存裸片。報道稱該技術的具體實現方式是在處理器和 HBM 芯片間建立硅中介層。
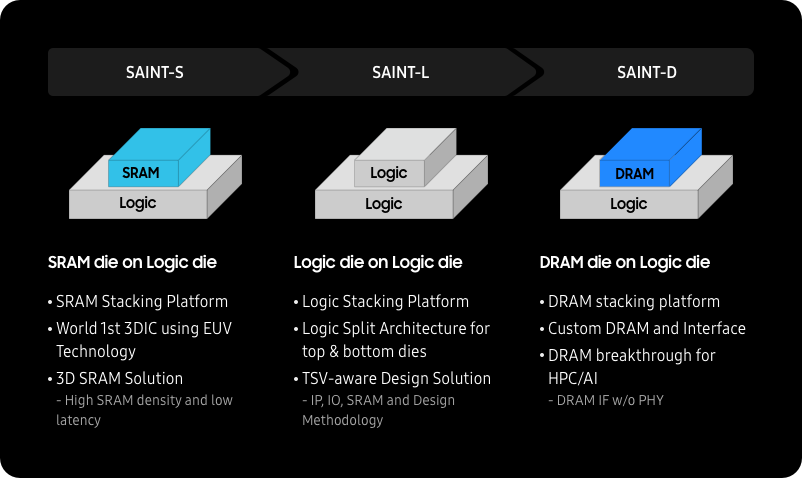
▲ 三星電子 SAINT 先進封裝技術家族
三星電子近期在三星代工論壇 2024 北美場上表示,其 SAINT-D 技術目前正處于概念驗證階段。

▲ 三星 AI 解決方案,中即 SAINT-D 技術
韓媒表示,SAINT-D 技術有望改變 AI 半導體領域的游戲規則:
目前 HBM 內存與處理器之間采用 2.5D 封裝連接,兩者之間存在一定距離,不僅引入了更大傳輸延遲,同時還影響了電信號質量、提升了數據移動功耗。
而 SAINT-D 技術將處理器和 HBM 內存的距離降到更低,有利于 AI 加速器芯片進一步釋放性能潛力。
對于三星電子整體而言,由于可提供從先進節點代工、HBM 內存生產到整體封裝集成的全流程“交鑰匙”服務,SAINT-D 的應用也可帶動 HBM 和代工業務的發展。
根據市場研究機構 MGI 的數據,SAINT-D 等先進封裝市場的規模將從 2023 年的 345 億美元成長至 800 億美元。












評論