使用電子噪聲和抗蝕劑模糊模型預測隨機EUV缺陷密度
近年來,首次直接解決了EUV光刻中二次電子噪聲的統計及其對缺陷概率的影響[1]。在本文中,我們將考慮一些更新的 EUV 抗蝕劑模糊模型,包括化學放大 (CAR) 和金屬氧化物 (MOR) 類型。
首先,讓我們回顧一下推導 EUV 隨機缺陷概率的過程,同時考慮二次電子噪聲。光子吸收的特征是經典的分裂或變薄泊松分布[2]。假設每個吸收的EUV光子釋放的電子數遵循整數的均勻分布作為概率質量函數[1]。當考慮電子散射時,由此產生的有效“模糊”將嘈雜的光子吸收曲線替換為以模糊比例參數為特征的平滑曲線。
然而,這只會更新每個“像素”的平均電子數。在這里,像素代表抗蝕劑分子的尺寸,對于CAR[3,4],可以認為是2 nm x 2 nm,對于MOR[4,5],可以認為是1 nm x 1 nm。我們可以應用累積分布函數(CDF)來預測像素被預期的概率是否錯誤地高于或低于打印閾值。該 CDF 考慮了像素中模糊的平均電子數以及電子數噪聲。為了計算給定位置出現給定尺寸缺陷的概率,我們只需計算缺陷區域內像素的此類概率的乘積[1]。這樣做的一個自然結果是,較大的缺陷(包含更多像素)的概率將比較小的缺陷小得多。當我們考慮缺陷概率的音高依賴性時,這將是稍后提出的一個重要問題。
抗蝕劑模糊的意義:對比度的降低
抗蝕劑模糊本質上是抗蝕劑對光照的響應,這會導致對比度相對于初始光學圖像下降。已知化學放大的抗蝕劑因酸擴散而產生模糊[4],而EUV抗蝕劑已知因EUV光子吸收釋放的電子而產生模糊。
酸模糊函數一般為高斯形狀[4];與模糊前圖像的卷積形成模糊后圖像。
電子模糊影響與卷積處理類似,但形狀實際上是兩個函數的差異,這允許零距離處的概率密度為零,但在合理的非零距離處允許峰值概率密度[6]。其中一個函數(“內”函數)具有較短的指數衰減長度,這有助于設置峰值概率距離,而另一個函數(“外部”函數)具有較長的指數衰減長度,它定義了長程尾部,對應于實驗確定的電子衰減長度[7,8]。
降低對比度意味著所有值都更接近平均值。
電子模糊實際上包括能量從光電子能量開始下降到(接近)零的電子行進的距離。雖然電子在給定能量下的平均自由程可能約為 1 nm,但最終的電子模糊尾衰減長度很容易超過這個長度。
這兩種形式的模糊都會將對比度降低到可以針對感興趣的特定情況進行計算的程度。例如,具有標準差 s 的高斯形狀與間距 p 的正弦波卷積會導致對比度降低 exp(-2*[pi*s/p]^2) 倍數,而尺度參數 b 與相同正弦波卷積的指數形狀導致對比度降低 1/(1+[2*pi*b/p]^2)。當取兩個指數或高斯的差值時,必須將結果除以函數相對權重的差值,以重新歸一化結果。
降低對比度使所有像素電子數(或酸數)值更接近平均值。因此,隨著對比度的進一步降低,CDF 計算將給出接近 50% 的像素概率。另一方面,改進的對比度意味著距離特征邊緣較遠的像素的概率將從 50% 進一步降低。
更新具有代表性的抗蝕劑模糊模型
深入研究文獻,我們可以找到一些信息,引導我們找到 EUV 抗蝕劑的適當模糊形狀。通過模擬EUV暴露引起的降解(化學變化),發現了基于PMMA的EUV抗蝕劑模型的電子模糊形狀[9]。通過高斯差異(一個具有 s=3.4 nm,另一個(相對權重 79.4%),s=2.7 nm)來最好地實現與其結果的擬合。在將該電子模糊函數與光子吸收曲線卷積后,隨后將 s=5nm 高斯模糊 [4] 與結果卷積,以獲得代表 CAR 情況的酸曲線。對于MOR的情況,我們可以參考Bespalov等[10]中的數據,該數據顯示,一個1.6 eV的電子穿透了20 nm厚的SnOH抗蝕劑,然后明顯地從基板反射回來,具有劑量依賴性度,整個厚度,1.2 eV的電子也做同樣的事情,但被捕獲在距離抗蝕劑頂部~11-12 nm的地方, 當電子動能達到陷阱能量時。
請注意,如果電子甚至沒有到達基板,則無法測量抗蝕劑厚度,因為支撐底部將被溶解。從指數擬合來看,1.2 eV 電子衰減長度為 1.4 nm,而 1.6 eV 電子衰減長度為 3.2 nm。由于所有電子必須通過 1.6 eV 才能獲得捕獲能量,因此外部模糊標度參數被認為是兩者中較大的一個 (3.2 nm)。選擇內部尺度參數(0.448 nm)和相對權重(14%)以滿足以下兩個條件:(1)零距離處的零概率,以及(2)1 nm處的峰值概率,與預期的分子大小相匹配[5]。圖1顯示了上述處理產生的電子模糊函數形狀。

圖 1.有機和金屬氧化物抗蝕劑的代表性電子模糊函數形狀。文本中提供了參數。
EUV 抗蝕劑的代表性電子噪聲模型
以前[1,11],電子噪聲被建模為每個光電子(即吸收光子)在5到9的整數范圍內均勻分布。這允許一個電子逃逸基于Sn的MOR層。然而,對于CAR情況,我們將對Míguez等人在[9]中的結果應用相同的處理,每個吸收光子的整數范圍為8到16,包括一個逃逸的電子。如[1]所示,對于范圍[p,q],最小3s/avg電子噪聲可以計算為3*sqrt([n^2-1]/12)/m,其中m=(p+q)/2和n=q-p+1。這為CAR情況提供了55%,對于MOR情況(如之前發表的[1])為61%。
將像素概率與 EUV 隨機指標效應結合使用
像素有缺陷的概率是使用每個光子每個可能的電子數的泊松CDF平均值計算的[1]。每個光子給定電子數的泊松分布的CDF通常用伽馬函數[12]來描述,基本上是exp(-N)*Nj/j!的總和(j=0到k,測試吸收的光子數),N是目標或閾值吸收的光子數。對于CAR的情況,酸量子產率(35%)乘以吸收的光子數。模糊的效果是通過縮小差異,有效地使給定像素處的吸收光子數接近平均值(在所有像素上)。縮小因子是前面提到的在吸收的光子輪廓與模糊輪廓卷積的背景下的對比度降低因子。
計算了三種情況下的像素缺陷概率:(1)ArF浸沒(ArFi)40 nm半間距,80 nm厚抗蝕劑(3/um吸收),2 nm像素,s=5 nm高斯酸模糊,(2)EUV 20 nm半間距,40 nm厚CAR(5/um吸收),2 nm像素,s=5 nm高斯酸模糊,(3)EUV 20 nm半間距, 40 nm厚的MOR(20/um吸收),1 nm像素。前面介紹了EUV CAR和MOR的電子模糊形狀(圖1)。結果如圖 2 所示。
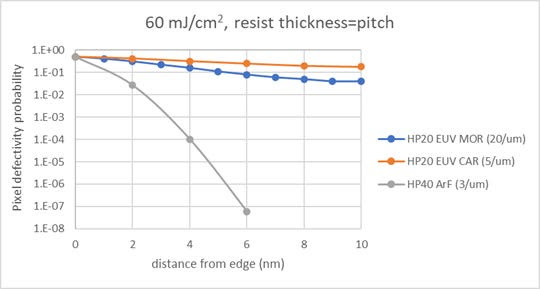
圖 2.像素缺陷概率(未能達到閾值)作為距半間距線邊緣距離的函數,適用于三種不同的抗蝕劑曝光情況。文中提供了抗蝕劑條件。
顯然,在整個 20 nm 暴露的半間距中,EUV 曝光的缺陷比 ArFi 40 nm 半間距的缺陷呈指數級增長。這就是為什么隨機缺陷只有在 EUV 光刻技術的出現后才成為一個明顯的問題。
了解像素概率可以計算各種 EUV 隨機效應的概率。然而,必須謹慎地形成對這些概率的解釋。
邊緣邊界像素
首先要記住的是,邊緣像素概率始終為 50%。由于它代表特征的邊邊界,因此我們可以在評估隨機效應的實際概率時將其排除在考慮之外。
邊緣粗糙度
與邊緣邊界像素相鄰的像素線可用于評估邊緣粗糙度。對于 60 mJ/cm2 的 EUV 入射劑量,CAR 和 MOR 情況每像素有 20-30 個吸收光子(分別為 5/um 和 20/um 吸收)。兩種類型的抗蝕劑的電子噪聲貢獻也相當,與 MOR 相比,CAR 較大的平均電子/光子被更大的擴散所補償。因此,對于兩種抗蝕劑,與 20 nm 半間距邊緣邊界相鄰的像素的像素概率為 ~30-50%。通過將該概率除以 40 nm 間距 x(2 x 像素大小)的實際平鋪面積,可以找到與邊界相鄰的單個缺陷像素的密度。等效地,我們可以通過往復運動該密度來找到每個缺陷的面積,大致每 2 個像素出現一個邊緣缺陷/30-50% = 4-6 像素(CAR 為 8-12 nm,MOR 為 4-6 nm)。這與在先前發表的圖中觀察到的參差不齊的邊緣一致(例如,[13])。
邊緣缺口/突起缺陷
像素概率從 50% 的邊緣開始,并逐漸減少,從邊緣向特征內部移動。因此,由于泊松噪聲 + 電子噪聲而形成缺陷的最有可能的位置是邊緣。因此,從線邊緣延伸幾nm并沿線延伸幾nm的邊緣缺陷可以具有較高的缺陷密度,如圖3所示。此處用于計算缺陷密度的平鋪面積為間距 x(缺陷長度 + 1 像素)。
 圖 3.三個抗蝕劑工況的邊緣缺陷概率。左圖:40 nm間距20 nm溝槽EUV MOR,40 nm厚度,60 mJ/cm2。中心:40 nm 間距 20 nm 溝槽 EUV CAR,40 nm 厚度,60 mJ/cm2。右圖:80 nm間距ArFi CAR,目標為負極抗蝕劑中的20 nm溝槽,厚度為40 nm,30 mJ/cm2。假設 EUV 和 ArFi CAR 均存在 s=5 nm 高斯酸模糊。假設 TE ArFi 極化和 50% TE/50% TM EUV 極化。
圖 3.三個抗蝕劑工況的邊緣缺陷概率。左圖:40 nm間距20 nm溝槽EUV MOR,40 nm厚度,60 mJ/cm2。中心:40 nm 間距 20 nm 溝槽 EUV CAR,40 nm 厚度,60 mJ/cm2。右圖:80 nm間距ArFi CAR,目標為負極抗蝕劑中的20 nm溝槽,厚度為40 nm,30 mJ/cm2。假設 EUV 和 ArFi CAR 均存在 s=5 nm 高斯酸模糊。假設 TE ArFi 極化和 50% TE/50% TM EUV 極化。
顯示了一個 ArF 情況以供參考,表明缺陷密度如何呈指數級降低,這要歸功于在較厚的抗蝕劑中吸收了更多的光子,沒有電子噪聲,并且模糊對更大間距的影響要小得多。與MOR(1 nm)相比,CAR(2 nm)的像素尺寸更大也是不利的,因為與較小的MOR缺陷相比,EUV CAR缺陷的缺陷密度更差,如圖3所示。
換行符
一條有缺陷的像素線穿過一條線的概率在很大程度上取決于跨越該線的像素數量。這個數字當然與線寬成正比,例如,半間距。這導致換行概率隨著音高的降低呈指數級增加,如圖 4 所示。這里用于計算缺陷密度的平鋪面積為間距 x 2nm(即缺陷寬度 + 1 像素)。請注意,即使缺陷密度高達2e5/cm2,這也相當于524 um2/缺陷,即無法在一張SEM圖片中捕獲它。
 圖 4.MOR 換行符的概率與音高的函數關系。這些是 1 nm 寬的抗蝕劑條未能暴露在閾值以上的情況。
圖 4.MOR 換行符的概率與音高的函數關系。這些是 1 nm 寬的抗蝕劑條未能暴露在閾值以上的情況。
當間距減小到 20 nm 時,更寬的換線可能會產生較大的缺陷密度。20 nm厚的MOR中2 nm寬的換線可以具有744 / cm2的缺陷密度。在這里,平鋪區域為 20 nm 間距 x 3 nm(即 2 nm 寬度 + 1 像素)。
局部模糊變化(Local Blur Variation)
模糊的局部變異可能在之前提出過[14,15]。這也會對缺陷密度產生很大影響。將外部電子模糊尺度參數從 3.2 nm 更改為 5 nm,同時保持零距離處的零概率和 1 nm 處的峰值概率,導致圖 3 的 4 nm x 4 nm 邊緣缺陷的密度從 200/cm2 增加到 1e5/cm2 以上!因此,晶圓上的實際缺陷密度取決于晶圓上 3.2 nm 情況與 5 nm 情況的相對概率。對于每種不同的抗蝕劑涂層,這可能不同。
光學失去了對光刻的控制
隨著間距的縮小,它不再是波長或 NA,而是抵抗模糊、電子噪聲和分子大小,這些已成為確定實際分辨率極限的主要因素。除了圖像對比度和焦深,缺陷密度也成為新的考慮因素。這就是為什么傳統的投影光刻方案在某些時候必須依賴多圖案化[16]。






評論